英特尔先进封装:助力AI芯片高效集成的技术力量
2025-03-28 15:40:40AI云资讯7506
在AI发展的浪潮中,一项技术正在从“幕后”走向“台前”,也就是半导体先进封装(advancedpackaging)。这项技术能够在单个设备内集成不同功能、制程、尺寸、厂商的芯粒(chiplet),以灵活性强、能效比高、成本经济的方式打造系统级芯片(SoC)。因此,越来越多的AI芯片厂商青睐这项技术。
英特尔自本世纪70年代起持续创新,深耕封装技术,积累了超过50年的丰富经验。面向AI时代,英特尔正在与生态系统伙伴、基板供应商合作,共同制定标准,引领整个行业应用先进封装技术。秉持“系统工艺协同优化”(STCO)的理念,英特尔代工不仅能够向客户提供传统的封装、互连、基板等技术,还涵盖了系统级架构和设计服务,以及热管理和功耗管理等全方位支持工作。
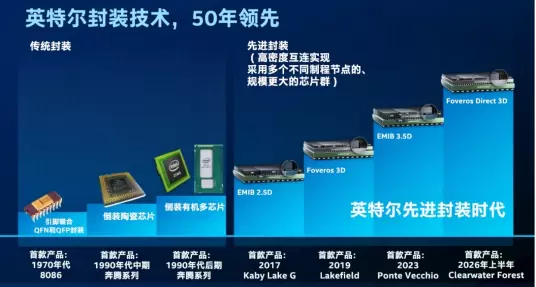
丰富全面的技术组合
英特尔代工的先进系统封装及测试(Intel Foundry ASAT)的技术组合,包括FCBGA 2D、FCBGA 2D+、EMIB 2.5D、EMIB 3.5D、Foveros 2.5D & 3D和Foveros Direct 3D等多种技术。

左上:FCBGA 2D、右上:EMIB2.5D、左下:Foveros2.5D & 3D、右下:EMIB 3.5D
·FCBGA 2D是传统的有机FCBGA(倒装芯片球栅格阵列)封装,适用于成本敏感、I/O数量较少的产品。
·FCBGA 2D+在此基础上增加了基板层叠技术(substrate stacking),能够减少高密度互连的面积,降低成本,特别适合网络和交换设备等产品。
·EMIB(嵌入式多芯片互连桥接)2.5D技术通过基板内的微型硅桥连接芯片,适用于高密度的芯片间连接,在AI和高性能计算(HPC)领域表现出色。
·EMIB 3.5D则在此基础上引入了3D堆叠技术,芯片可以垂直堆叠在有源或无源的基板上,再通过EMIB技术连接,增加了堆叠的灵活性,能够根据IP的特性选择垂直或水平堆叠,同时避免使用大型的中介层。
·Foveros 2.5D和3D技术采用基于焊料的连接方式,而不是基底连接,适合高速I/O与较小芯片组分离的设计。
·Foveros Direct 3D技术则通过铜和铜直接键合,实现更高的互连带宽和更低的功耗,从而提供卓越的性能。
值得注意的是,这些技术并非互斥,而是在一个封装中可以同时采用,为复杂芯片的设计提供了极大的灵活性。在商业层面,这体现了英特尔对封装细分市场的重视。
EMIB:AI芯片封装的理想选择
针对AI芯片的先进封装需求,与业界其它晶圆级2.5D技术,例如硅中介层、重布线层(RDL)相比,EMIB 2.5D技术具有诸多优势。
第一,成本效益。EMIB技术采用的硅桥尺寸非常小,相比于传统的大尺寸中介层,制造时能更高效地利用晶圆面积,减少空间和资源的浪费,综合成本更低。

第二,良率提升。EMIB技术省略了晶圆级封装(wafer level assembly)这一步骤,减少了模具、凸点等复杂工艺带来的良率损失风险,从而提高了整体生产过程的良率。
第三,生产效率。与晶圆级技术相比,EMIB技术的制造步骤更少、复杂度更低,因此生产周期更短,能够为客户节省宝贵的时间。在市场动态快速变化的情况下,这种时间优势能够帮助客户更快地获得产品验证数据,加速产品上市。
第四,尺寸优化。晶圆级技术需要在基板上方添加中介层,而EMIB则将硅桥嵌入基板,极大地提高了基板面积的利用率。同时,基板的尺寸与集成电路面板的格式相匹配,采用EMIB能够在单个封装中集成更多芯片,从而容纳更多的工作负载。
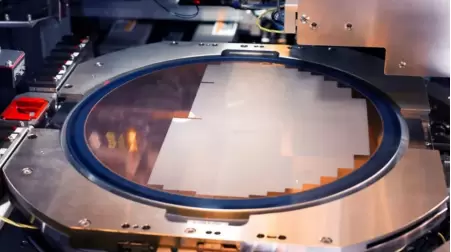
第五,供应链与产能。英特尔拥有成熟的供应链和充足的产能,确保了EMIB能够满足客户对先进封装解决方案的需求。
展望未来
展望未来,英特尔正在研发120×120毫米的超大封装,并计划在未来几年内向市场推出玻璃基板(glasssubstrate)。与目前采用的有机基板相比,玻璃基板具有超低平面度、更好的热稳定性和机械稳定性等独特性能,能够大幅提高基板上的互连密度,为AI芯片的封装带来新的突破。
英特尔在AI时代的先进封装技术领域不断创新,将继续引领和推动行业发展,为全球半导体产业注入新的活力。
相关文章
- 全球首款AI角色舱Dipal D1亮相英特尔发布会
- 联想直营店&英特尔2026大学生新质生产力创新大赛圆满收官
- 英特尔第三代酷睿Ultra强芯驱动!联想YOGA Pro双旗舰重塑AI创作体验
- 英特尔酷睿Ultra 200S Plus新U上市,微星板U套装同步开售,全系享4年质保
- 引领AI PC新标杆,第三代英特尔酷睿Ultra重新定义轻薄本
- 英特尔x抖音商城「科技晚」:端云协同混合智算,共启智能科技新未来
- 受人工智能需求影响,英特尔消费级CPU产品或面临大规模涨价
- 轻薄、AI、数日续航、性能强劲,第三代英特尔酷睿Ultra新品重磅上市
- 释放极致游戏性能!英特尔酷睿Ultra 200S Plus发布
- 第三代英特尔酷睿Ultra新品重磅发布,重新定义轻薄本的性能边界
- 英特尔发布面向高端游戏本的酷睿Ultra 200HX Plus处理器
- 像素蛋糕优化适配英特尔Panther Lake平台,AI修图效率提升145%
- 英特尔在英伟达GTC大会的完美时机亮相:智能体AI将CPU变为新瓶颈
- 荣耀MagicBook全线新品亮相英特尔第三代酷睿Ultra处理器新品分享会
- OpenClaw 全新搭档:英特尔芯铭凡M2 Pro 重塑隐私与实用平衡
- ThinkPad AI PC亮相英特尔第三代酷睿Ultra处理器新品分享会
人工智能企业
更多>>人工智能硬件
更多>>人工智能产业
更多>>人工智能技术
更多>>- 发布即适配| 天数智芯全力支持腾讯混元Hy3 preview 开源落地,共推国内大模型产业普惠
- Seedance 2.0面向企业公测,豆包大模型日均Token使用量突破120万亿
- 端到端OCR模型第一!百度千帆Qianfan-OCR正式发布
- 云知声Unisound U1-OCR大模型发布!首个工业级文档智能基础大模型,开启OCR 3.0时代
- 基石智算上线 MiniMax M2.5,超强编程与智能体工具调用能力
- 昇腾原生支持,科学多模态大模型Intern-S1-Pro正式发布并开源
- 百度千帆深度研究Agent登顶权威评测榜单DeepResearch Bench
- 在MoltBot/ClawdBot,火山方舟模型服务助力开发者畅享模型自由









