英特尔实现3D先进封装技术的大规模量产
2024-01-25 14:59:59AI云资讯1426
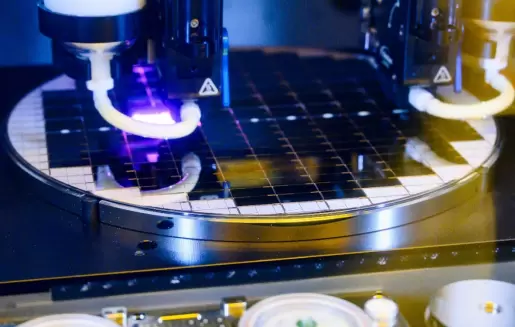
英特尔宣布已实现基于业界领先的半导体封装解决方案的大规模生产,其中包括英特尔突破性的3D封装技术Foveros,该技术为多种芯片的组合提供了灵活的选择,带来更佳的功耗、性能和成本优化。
这一技术是在英特尔最新完成升级的美国新墨西哥州Fab 9投产的。英特尔公司执行副总裁兼首席全球运营官Keyvan Esfarjani表示:“先进封装技术让英特尔脱颖而出,帮助我们的客户在芯片产品的性能、尺寸,以及设计应用的灵活性方面获得竞争优势。”
这一里程碑式的进展还将推动英特尔下一阶段的先进封装技术创新。随着整个半导体行业进入在单个封装中集成多个“芯粒”(chiplets)的异构时代,英特尔的Foveros和EMIB(嵌入式多芯片互连桥接)等先进封装技术提供了速度更快、成本更低的路径,以实现在单个封装中集成一万亿个晶体管,并在2030年后继续推进摩尔定律。
英特尔的3D先进封装技术Foveros是业界领先的解决方案,在处理器的制造过程中,能够以垂直而非水平方式堆叠计算模块。此外,Foveros让英特尔及其代工客户能够集成不同的计算芯片,优化成本和能效。
英特尔将继续致力于推进技术创新,扩大业务规模,满足不断增长的半导体需求。
相关文章
- 绿联携AI NAS参展英特尔峰会,定义智能存储新生态
- 苹果公司已达成协议,将再次使用英特尔制造的芯片
- 绿联AI NAS亮相英特尔“智存无界·芯联未来“峰会,展现AI存储创新实力
- OpenAI宣布与AMD、英伟达、英特尔、微软及博通达成超级合作,合力加速AI发展
- 面向AI算力需求,英特尔推进大尺寸先进封装创新
- 全球首款AI角色舱Dipal D1亮相英特尔发布会
- 联想直营店&英特尔2026大学生新质生产力创新大赛圆满收官
- 英特尔第三代酷睿Ultra强芯驱动!联想YOGA Pro双旗舰重塑AI创作体验
- 英特尔酷睿Ultra 200S Plus新U上市,微星板U套装同步开售,全系享4年质保
- 引领AI PC新标杆,第三代英特尔酷睿Ultra重新定义轻薄本
- 英特尔x抖音商城「科技晚」:端云协同混合智算,共启智能科技新未来
- 受人工智能需求影响,英特尔消费级CPU产品或面临大规模涨价
- 轻薄、AI、数日续航、性能强劲,第三代英特尔酷睿Ultra新品重磅上市
- 释放极致游戏性能!英特尔酷睿Ultra 200S Plus发布
- 第三代英特尔酷睿Ultra新品重磅发布,重新定义轻薄本的性能边界
- 英特尔发布面向高端游戏本的酷睿Ultra 200HX Plus处理器
人工智能企业
更多>>人工智能硬件
更多>>人工智能产业
更多>>人工智能技术
更多>>- 高德发布鸿蒙首个生成式 UI 开源框架 AGenUI,告别传统 UI 开发模式
- 发布即适配| 天数智芯全力支持腾讯混元Hy3 preview 开源落地,共推国内大模型产业普惠
- Seedance 2.0面向企业公测,豆包大模型日均Token使用量突破120万亿
- 端到端OCR模型第一!百度千帆Qianfan-OCR正式发布
- 云知声Unisound U1-OCR大模型发布!首个工业级文档智能基础大模型,开启OCR 3.0时代
- 基石智算上线 MiniMax M2.5,超强编程与智能体工具调用能力
- 昇腾原生支持,科学多模态大模型Intern-S1-Pro正式发布并开源
- 百度千帆深度研究Agent登顶权威评测榜单DeepResearch Bench









