半导体未来三大支柱:先进封装、晶体管和互连
2024-12-23 19:14:38AI云资讯3598
英特尔在前沿技术领域的探索和布局具有行业标杆意义,其发布的技术路线图和成果为半导体行业提供了重要参考方向。
在IEDM 2024大会上,英特尔发布了7篇技术论文,展示了多个关键领域的创新进展。这些技术涵盖了从FinFET到2.5D和3D封装(EMIB、Foveros、Foveros Direct),即将在Intel 18A节点应用的PowerVia背面供电技术,以及全环绕栅极(GAA)晶体管RibbonFET等。此外,英特尔还揭示了一些面向未来的先进封装技术,为推动行业发展提供了新的视角。
在这些前沿技术中,三个核心领域尤为值得关注:面向AI发展的先进封装、晶体管微缩技术和互连微缩技术。在IEDM 2024大会上,英特尔代工高级副总裁兼技术研究总经理Sanjay Natarajan详细介绍了这些领域的关键突破。

先进封装的突破:选择性层转移技术
异构集成已经成为当今芯片界的主流实现性能提升的手段。但是异构集成技术面临着很大的挑战。当前异构集成技术主要采用“晶圆对晶圆键合”(Wafer-to-Wafer HB)或“芯片对晶圆键合”(Chip-to-Wafer HB),会因顺序装配芯粒而导致吞吐量、芯片尺寸和厚度受限。
英特尔通过选择性层转移(Selective Layer Transfer)技术,突破了当前异构集成的技术瓶颈。这项技术能够以超高效率完成超过15,000个芯粒的并行转移,仅需几分钟即可实现相较于传统方法数小时或数天的提升。其创新性地实现了亚微米级芯粒的转移,支持仅1平方毫米大小、厚度为人类头发1/17的芯粒。这提供了一种灵活且成本效益显著的异构集成架构,使得处理器与存储器技术的混合搭配成为可能。Intel Foundry率先采用无机红外激光脱键技术,实现了芯粒转移的技术突破,推动了旗舰AI产品开发所需的先进异构集成技术的发展。
英特尔代工高级副总裁技术研究总经理Sanjay Natarajan表示:“我们有理由期待这一技术能够像PowerVia背面供电技术一样在业内普及。我们将积极开创并推动这项技术的发展,我认为我们会看到业内领先企业都逐步采用这一技术。”
面向AI时代,英特尔提出了全面的封装解决方案,以实现AI系统的大规模量产。除了选择性层转移技术,英特尔还聚焦于:
先进内存集成(memory integration):解决容量、带宽和延迟瓶颈,提升性能。
混合键合(hybrid bonding)互连的间距缩放:实现异构组件间的高能效和高带宽密度连接。
模块化系统的扩展:通过连接解决方案降低网络延迟和带宽限制。
GAA晶体管的突破:物理和二维材料
晶体管技术的进步一直以来都是英特尔的主业之一,英特尔的目标是到2030年实现一万亿晶体管的宏伟目标。
Intel展示了其在Gate-All-Around(GAA)RibbonFET晶体管上的技术突破,成功将栅极长度缩小至6nm,并实现1.7nm硅通道厚度。通过对硅通道厚度和源漏结的精准工程设计,有效减少了漏电流和器件退化,提高了晶体管在极短栅极长度下的性能稳定性。英特尔研究数据显示,与其他先进节点技术相比,在6nm栅极长度下,RibbonFET在短栅极长度下具备更高的电子迁移率和更优的能效特性。除此之外,RibbonFET实现了最佳的亚阈值摆幅(Subthreshold Swing,SS)和漏电流抑制性能(DIBL)。
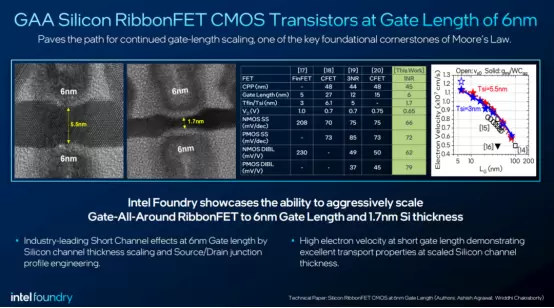
左图是透射电子显微镜(TEM)图像,中间展示看这些晶体管的部分关键参数,右图是栅极长度与电子速度关系图
这一进展展示了在短沟道效应优化方面的行业领先水平,这为未来更高密度、更低功耗的芯片设计奠定了基础,同时推动了摩尔定律的持续发展,满足了下一代计算和AI应用对半导体性能的严苛需求。
为了推进GAA晶体管技术的发展,英特尔也将目光瞄准了二维半导体材料。
据Sanjay Natarajan的介绍,具体而言,英特尔在GAA技术中引入了二维(2D)NMOS和PMOS晶体管,该晶体管以二维MoS2为沟道材料,结合高介电常数的HfO2作为栅氧化层,通过ALD(原子层沉积)工艺实现精确控制。下图的横截面成像清晰展示了栅极金属、HfO₂氧化物和二维MoS2之间的结构集成,其整体厚度在纳米级别,漏源间距(L_SD)小于50nm,次阈值摆幅(SS)低于75mV/d,最大电流性能(I_max)达到900µA/µm以上,能够显著提升栅极对沟道的控制能力。
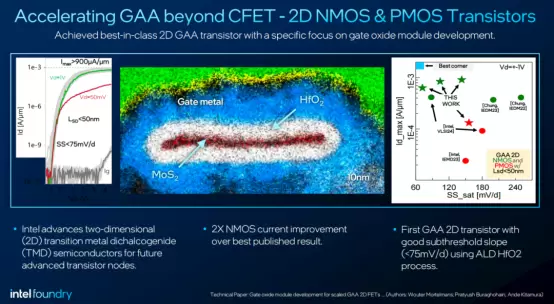
右侧的图表中将Intel的研究结果(THIS WORK)与其他同类研究进行了对比,显示在驱动电流和次阈值摆幅上的明显优势。
英特尔的研究验证了结合GAA架构和2D材料,晶体管性能堪称飞跃。而且一旦英特尔将基于硅的沟道性能推至极限,采用2D材料的GAA晶体管很有可能会成为下一步发展的合理方向。
就英特尔所观察到的而言,晶体管数量的指数级增长趋势,符合摩尔定律,从微型计算机到数据中心,晶体管数量每两年翻倍。但是,随着AI工作负载的持续增加,AI相关能耗可能会在2035年超越美国当前的总电力需求,能源瓶颈成为未来计算发展的关键挑战。因此,未来需要的是新型晶体管。下一代晶体管需要具备超陡次阈值摆幅(低于60mV/dec)和极低的静态漏电流(I_off),支持在超低供电电压(<300mV)下运行。
英特尔也在材料和物理层面不断探索,并在IEDM上展示了采用Ge(锗)纳米带结构的晶体管,其9nm厚度和结合氧化物界面的创新设计,为实现低功耗和高效传输奠定了基础。Intel进一步研究结合高介电常数材料和新型界面工程,以开发更加节能高效的下一代晶体管。
英特尔也呼吁整个行业共同推动晶体管技术的革命,以满足万亿晶体管时代中AI应用的需求。通过对过去60年晶体管发展的总结,Intel同时提出了未来10年的发展目标:1)必须开发能够在超低供电电压(<300mV)下工作的晶体管,以显著提高能效,为普遍化的AI应用提供支持;2)持续增加晶体管数量的技术是可行的,但能源效率的革命性突破将是未来发展的重点。

互连缩放的突破:钌线路
随着晶体管和封装技术的持续微缩,互连已成为半导体体系中的第三个关键要素。这些互连导线负责连接数以万亿计的晶体管。然而,我们清晰地看到,铜互连的时代正逐渐走向尾声。铜互连存在一个实际问题:使用时需要添加阻挡层和籽晶层。随着尺寸的不断缩小,这些相对高电阻的层占据了更多的可用空间。英特尔观察到,当线宽不断缩小时,铜线的电阻率呈指数级上升,达到难以接受的程度。因此,尽管晶体管尺寸越来越小、密度和性能不断提升,但传统的布线方式已无法满足连接所有晶体管的需求。
英特尔的突破在于采用具有高成本效益的空气间隙钌(Ru)线路,作为铜互连的潜在替代方案。这个空气间隙解决方案无需昂贵的光刻技术,也不需要自动对准通孔工艺。它巧妙地将空气间隙、减法钌工艺和图案化相结合,有望打造出合理的下一代互连技术,使之与未来的晶体管和封装技术相匹配。
这种新工艺在小于25nm的间距下,实现了在匹配电阻条件下高达25%的电容降低,有效提升了信号传输速度并减少了功耗。高分辨率的显微成像展示了钌互连线和通孔的精确对齐,验证了没有发生通孔突破或严重错位的问题。减法钌工艺支持大规模生产(HVM),通过消除复杂的气隙排除区和选择性蚀刻需求,具备实际应用的经济性和可靠性。
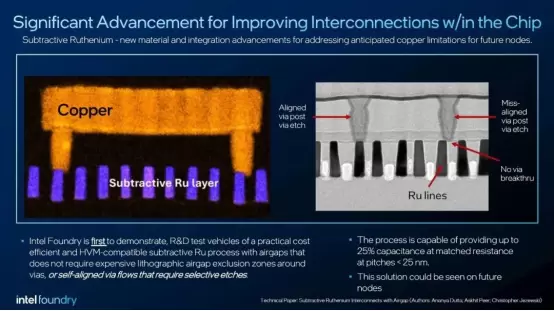
写在最后
半导体产业是一个高度复杂的生态系统,需要各方共同努力才能取得突破。英特尔在封装、晶体管和互连等领域的创新成果,为整个行业提供了宝贵的经验和启示。如同SanjayNatarajan所述,英特尔的目标是为整个行业提供路线图,以协调和统一我们所有的研发资金和努力。这样,下一代产品和服务就能推动整个行业向前发展,并继续推进摩尔定律。英特尔确实始终将自己视为摩尔定律的守护者,致力于承担这一责任,不断探索推进摩尔定律的新技术。这不仅是为了英特尔的利益,更是为了整个行业的共同利益。
相关文章
- 星思半导体:以专业手机直连卫星终端方案,助力卫星互联网应用的落地
- 星思半导体以手机直连卫星技术破解应急通信难题
- 星思半导体:全流程严苛测试,筑牢芯片稳定性
- 赋能电子、汽车、半导体、数据中心等产业,Fac Tec China电子工厂设施展邀您共赴6月2-4日上海世博展览馆
- AI赋能泛半导体智造行业研讨会暨喆塔科技南京创新研发总部揭牌仪式成功举办
- 国产ZCU芯片历史性突破:欧冶半导体工布565首发,打造智能汽车“区域智能中枢”
- 800G硅光芯片市占率稳步提升,孛璞半导体持续巩固领先地位
- 知满科技亮相深圳电博会,AI 赋能半导体全产业链
- 汉骅半导体8寸Micro-LED平台量产,万亿近眼显示市场迎来“中国芯”
- “嵌入式协同”破局:奥芯明许志伟解读AI时代的中国半导体设备之道
- 全球首只内存芯片ETF问世,DRAM正式从半导体“配角”升级为独立赛道
- 75天!首例半导体屋顶装配式高效制冷机房落地!
- 聚焦半导体温控细分赛道 酷凌时代以自主创新推进国产替代
- 运控+机器人双擎发力 新时达赋能半导体3C高端制造破局
- 海奇半导体新品发布会圆满落幕
- 富士胶片携压力测量新品亮相SEMICON China 助力半导体制造工艺
人工智能企业
更多>>人工智能硬件
更多>>人工智能产业
更多>>人工智能技术
更多>>- 高德发布鸿蒙首个生成式 UI 开源框架 AGenUI,告别传统 UI 开发模式
- 发布即适配| 天数智芯全力支持腾讯混元Hy3 preview 开源落地,共推国内大模型产业普惠
- Seedance 2.0面向企业公测,豆包大模型日均Token使用量突破120万亿
- 端到端OCR模型第一!百度千帆Qianfan-OCR正式发布
- 云知声Unisound U1-OCR大模型发布!首个工业级文档智能基础大模型,开启OCR 3.0时代
- 基石智算上线 MiniMax M2.5,超强编程与智能体工具调用能力
- 昇腾原生支持,科学多模态大模型Intern-S1-Pro正式发布并开源
- 百度千帆深度研究Agent登顶权威评测榜单DeepResearch Bench









