英特尔推进技术创新,以规模更大的封装满足AI应用需求
2025-06-11 08:27:45AI云资讯1744
为了推动AI等创新应用落地,使其惠及更广大的用户,需要指数级增长的算力。为此,半导体行业正在不断拓展芯片制造的边界,探索提高性能、降低功耗的创新路径。
在这样的背景下,传统上仅用于散热和保护设备的封装技术正在从幕后走向台前,成为行业热门趋势。与传统的封装技术不同,先进封装技术可以在单个设备内集成不同厂商、不同制程、不同大小、不同功能的芯片,从而为打造功能更强大、能效比更高的系统级芯片(SoC),带来了全新的可能性。

英特尔一直致力于将处理器、加速器和存储器等各种各样的芯片堆叠起来,组合到更大规模的封装中,帮助客户让产品性能“更上一层楼”。在2025IEEE电子器件技术大会(ECTC)上,英特尔分享了其封装技术的最新进展,这一大会由IEEE(电气电子工程师学会)电子封装协会主办,聚焦于封装、器件和微电子系统的科研、技术与教育,是封装领域的国际顶会。
具体而言,英特尔在封装领域的三大关键技术路径包括:提高封装的良率,确保供电稳定可靠,以及通过有效的热管理技术实现散热。
EMIB-T:稳定供电

英特尔的EMIB(嵌入式多芯片互连桥接)技术已经投入生产,突破了光罩尺寸的限制,实现了多芯片之间的高速互联。此外,通过硅通孔(TSV)技术,EMIB-T 优化了供电效率,并为集成高速HBM4,以及基于UCIe标准的芯粒提供了简便的解决方案。
热压键合:提高良率
随着封装尺寸越来越大,集成多芯片的复杂程度也在同步提升。英特尔计划通过探索高精度、大光罩热压键合(TCB)的先进工艺来提高良率和可靠性。

分解式散热器:高效散热
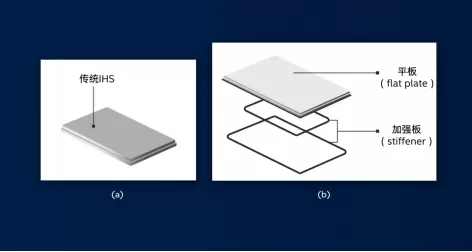
随着封装变得越来越复杂,尺寸也越来愈大,热设计功耗(TDP)也在不断增加。为应对散热层面的挑战,英特尔正在研发全新的分解式散热器技术,以及新一代热界面材料。这些创新可以更有效地将热量从热源传递到散热器的各个部分,进而提升整体的散热效率。
相关文章
- 绿联携AI NAS参展英特尔峰会,定义智能存储新生态
- 苹果公司已达成协议,将再次使用英特尔制造的芯片
- 绿联AI NAS亮相英特尔“智存无界·芯联未来“峰会,展现AI存储创新实力
- OpenAI宣布与AMD、英伟达、英特尔、微软及博通达成超级合作,合力加速AI发展
- 面向AI算力需求,英特尔推进大尺寸先进封装创新
- 全球首款AI角色舱Dipal D1亮相英特尔发布会
- 联想直营店&英特尔2026大学生新质生产力创新大赛圆满收官
- 英特尔第三代酷睿Ultra强芯驱动!联想YOGA Pro双旗舰重塑AI创作体验
- 英特尔酷睿Ultra 200S Plus新U上市,微星板U套装同步开售,全系享4年质保
- 引领AI PC新标杆,第三代英特尔酷睿Ultra重新定义轻薄本
- 英特尔x抖音商城「科技晚」:端云协同混合智算,共启智能科技新未来
- 受人工智能需求影响,英特尔消费级CPU产品或面临大规模涨价
- 轻薄、AI、数日续航、性能强劲,第三代英特尔酷睿Ultra新品重磅上市
- 释放极致游戏性能!英特尔酷睿Ultra 200S Plus发布
- 第三代英特尔酷睿Ultra新品重磅发布,重新定义轻薄本的性能边界
- 英特尔发布面向高端游戏本的酷睿Ultra 200HX Plus处理器
人工智能企业
更多>>人工智能硬件
更多>>人工智能产业
更多>>人工智能技术
更多>>- 高德发布鸿蒙首个生成式 UI 开源框架 AGenUI,告别传统 UI 开发模式
- 发布即适配| 天数智芯全力支持腾讯混元Hy3 preview 开源落地,共推国内大模型产业普惠
- Seedance 2.0面向企业公测,豆包大模型日均Token使用量突破120万亿
- 端到端OCR模型第一!百度千帆Qianfan-OCR正式发布
- 云知声Unisound U1-OCR大模型发布!首个工业级文档智能基础大模型,开启OCR 3.0时代
- 基石智算上线 MiniMax M2.5,超强编程与智能体工具调用能力
- 昇腾原生支持,科学多模态大模型Intern-S1-Pro正式发布并开源
- 百度千帆深度研究Agent登顶权威评测榜单DeepResearch Bench









